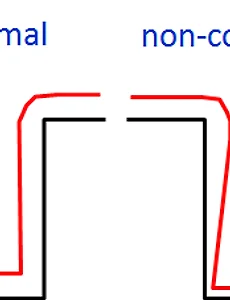 17. deposition 공정(1) (정의, requirements, 종류)
(1) deposition 공정이란? 웨이퍼 위에 원하는 분자 또는 원자 단위의 물질을 박막의 형태로 형성하는 공정. 목표하는 특성을 갖게 하기 위해서. ex) isolation(trench filling), gate stack(gate oxide, electrode), via/contact, ILD/IMD oxide, metal lines (2) requirements for desirable deposition quality: desired composition, low contaminants, good electrical and mechanical properties. ex) electrical properties: resistivity, dielectric characteristic, breakd..
2020. 9. 22.
17. deposition 공정(1) (정의, requirements, 종류)
(1) deposition 공정이란? 웨이퍼 위에 원하는 분자 또는 원자 단위의 물질을 박막의 형태로 형성하는 공정. 목표하는 특성을 갖게 하기 위해서. ex) isolation(trench filling), gate stack(gate oxide, electrode), via/contact, ILD/IMD oxide, metal lines (2) requirements for desirable deposition quality: desired composition, low contaminants, good electrical and mechanical properties. ex) electrical properties: resistivity, dielectric characteristic, breakd..
2020. 9. 22.