(1) 발생 가능한 문제점
1) channeling effect
<WHAT>
이온 주입 입사각에 따라 이온의 도달 깊이가 달라지면서 산포가 바뀌는 현상.

<WHY>
이온 주입 각도가 Si 격자 방향과 같을 때 다수의 이온들이 격자와 충돌없이 내부 깊숙이 도달.
→ 'long tail'처럼 doping 산포가 길게 늘어짐.
→ 깊이 분포의 예측이 어려워진다.
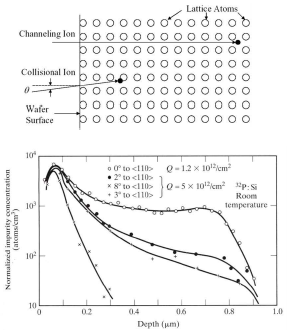
<해결법>

① axial tilt
: 각도를 기울여서 이온 주입 (wafer의 표면 방향을 이온 beam 방향으로부터 기울임).
→ 격자와의 충돌을 만들어 줌.
but, shadowing effect 발생 가능.

② planar rotation
: wafer 평판의 flat zone을 이온 beam 스캔 방향으로부터 기울임.
③ sacrificial oxide
: 표면에 산화막을 형성한 후 이온 주입.
→ 입사하는 이온들이 비정질의 산화막에 먼저 충돌하여 입사 방향을 randomizing.
④pre-amorphization
: 이온 주입 전 Si, Ge, F or Ar 등을 높은 dose로 주입.
→ wafer 상층의 격자를 비정질로 만들어 channeling이 발생할 경로를 없애줌.
2) shadowing effect
<WHAT>
이온 주입 mask의 측벽 아래에 그림자 영역처럼 이온 주입되지 않는 영역이 발생.
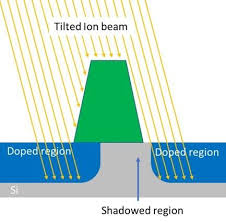
<해결법>
: 1차 이온 주입 후 wafer를 180º 회전하여 2차 이온 주입.
dose량을 1차와 2차에 반반씩 나누어 진행.
(2) 검사법 : sheet resistance (면저항)
<WHAT>
: 이온 주입 후 해당 영역의 저항을 측정하여 junction 깊이와 산포가 적절한지 확인하는 방법.
<WHY>
① visual inspection 방식으로 junction 깊이와 산포를 확인하는 것이 불가능함.
② 동일한 dose라도 doping 깊이가 목표보다 깊고 산포가 큰 경우 면저항 값이 증가하고,
반대의 경우는 면저항 값이 낮아짐.
<HOW>
: van der pauw 측정 방법 (4개의 단자를 이용).
∵ 면적의 넓이에 영향을 받지 않고 저항 측정이 가능하기 때문.
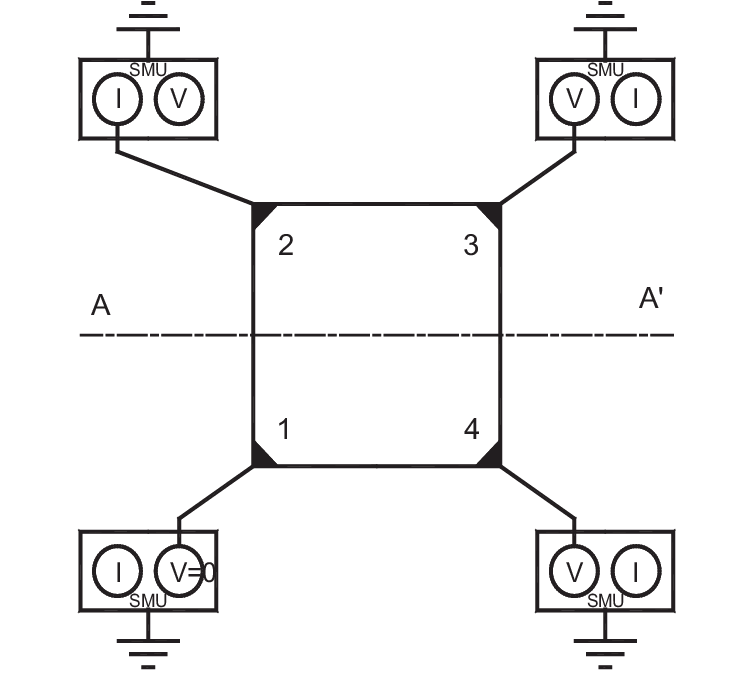
(3) 장비
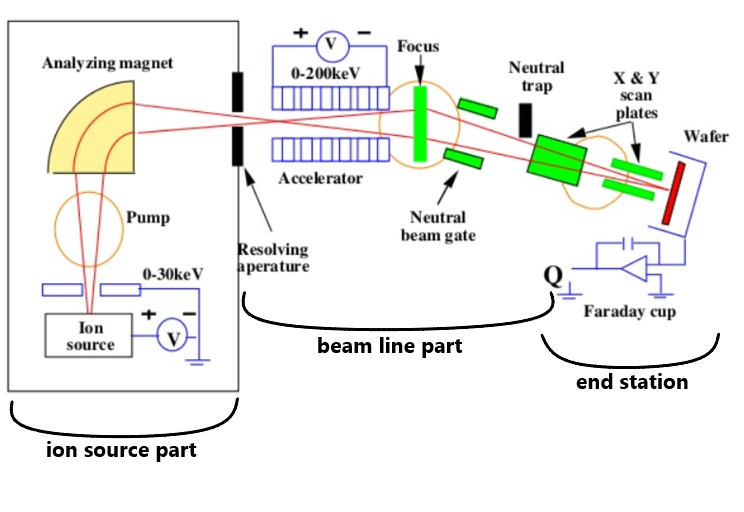
1) ion source part
① plamsa 만드는 원리로 source gas에서 이온 만듦.
* ion source (이온 공급기)
- source gas: Si → BF3, AsH3, PH3 / GaAs → SiH4 + H2.
- arc chamber 형태.
(필라멘트(cathode)와 금속판(anode)로 구성.
필라멘트에서 방출된 전자는 금속판으로 가속되며, 기체와 충돌하여 plasma를 생성)
② pump에서 pre-가속기로 이온들을 움직일 수 있도록 가속.
③ analyzing magnet의 자기장을 통해 회전 원심력(∵질량분리)으로 원하는 불순물의 이온만 걸러냄.
2) beam line part
① accelerator로 이온을 원하는 속도로 가속.
② focus lens 조정으로 이온들을 가운데로 집중 (beam형태로 만들어줌).
③ 중성빔 분해기로 원치 않는 중성 입자 걸러줌.
3) end station
① ion beam 전류를 모니터링하여 주입하는 이온의 양 확인 (faraday cup에 전류계를 연결하여 직접 측정).
<참고문헌>
이창훈, 반도체 소소제공, 더인 출판사, 2019, pp.180-184.
반도체 8대공정, 한국반도체기술교육원, pp.169-177.
'반도체 > 반도체 공정' 카테고리의 다른 글
| 17. deposition 공정(1) (정의, requirements, 종류) (0) | 2020.09.22 |
|---|---|
| 16. diffusion 공정 & oxidation 공정 (0) | 2020.06.29 |
| 14. ion implant 공정(1) (정의, parameter, annealing) (64) | 2020.06.11 |
| 13. cleaning 공정(2) (오염물질의 종류) (1) | 2020.06.09 |
| 12. cleaning 공정(1) (목적, 방식) (0) | 2020.06.05 |


